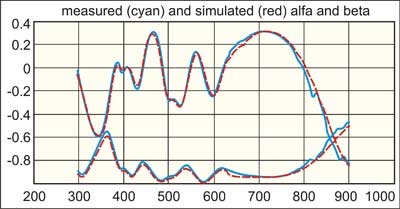
Измеренные и рассчитанные спектры параметров a, b для кремниевой решетки с периодом 140 нм (коэффициент корреляции спектров >0,996). Оцененные параметры: высота 321,6 нм, ширина = 98,2 нм, угол наклона стенок 2,9 градусов.

Измеренные и рассчитанные спектры параметров a и b пленки диоксида кремния (толщина 5,5 нм) на кремниевой подложке (коэффициент корреляции спектров >0,999).